製造現場で実績のあるマルチフィジックス解析により、信頼性と効率性に優れた設計を実現
Ansysのクラウドネイティブソリューションの比類のない容量で、最大規模のFinFET集積回路(IC)や3D/2.5Dマルチダイシステムであっても、納期をスピードアップできます。これらの強力なマルチフィジックス解析および検証ツールは、ファウンドリ認証済みの優れたサインオフ検証により、消費電力を削減し、パフォーマンスと信頼性を向上させ、プロジェクトリスクを低減します。
Ansysのクラウドネイティブソリューションの比類のない容量で、最大規模のFinFET集積回路(IC)や3D/2.5Dマルチダイシステムであっても、納期をスピードアップできます。これらの強力なマルチフィジックス解析および検証ツールは、ファウンドリ認証済みの優れたサインオフ検証により、消費電力を削減し、パフォーマンスと信頼性を向上させ、プロジェクトリスクを低減します。

フルチップに対応する容量を実現するクラウドネイティブなエラスティックコンピューティングアーキテクチャ
このビデオでは、電子設計自動化(EDA)市場向けに、Ansysの半導体解析製品で対処できる課題とソリューションについて簡単に説明します。現在、半導体設計は転換点を迎えており、設計者は製造技術の進歩により発生した2つの大きな課題に直面しています。1つ目は、ムーアの法則から5nm未満の高度なFinFETプロセス技術への移行に関する課題です。ナノシートGAA(Gate-All-Around)や裏面電源供給などの新しいトランジスタアーキテクチャが登場しています。2つ目は、マルチダイ設計、2.5D/3D-ICパッケージング、異種集積に関連した課題です。多くの場合、マルチフィジックスに関するさまざまな新しい課題に直面する中で、3D-ICで成功するために、これらの最先端技術が採用されています。新しいマルチフィジックスの課題としては、以下のものがあります。
2025年1月
2025 R1リリースでは、高度な寄生成分デバッグのための新しい製品PowerX™が追加され、大幅なスピードアップが実現しました。AnsysはTSMC社と協力して3D-IC製造における熱応力を評価するための新しい手法を開発しました。また、eShard™社とパートナーシップを結び、サイドチャネルセキュリティ分析を拡張したロバストなハードウェアセキュリティソリューションを提供します。
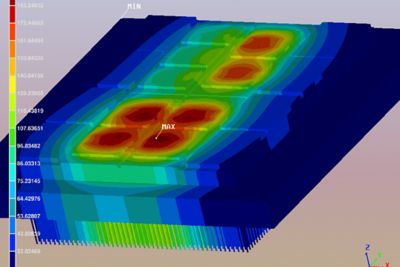
Ansysの半導体向け製品は、デジタルおよびトランジスタレベルの設計のためのサードパーティのIC実装フローをサポートするように設計された、マルチフィジックスEM/IR、熱および電磁界シミュレーションエンジンの包括的なスイートを提供します。
コア製品は、超大容量のクラウドネイティブのSeaScape™プラットフォーム上に構築されています。このプラットフォームでは、エラスティックコンピューティングによるビッグデータ機械学習アーキテクチャを使用して、数千のCPUコアでほぼリニアな拡張性をもたらします。
エンジニアリング課題に直面している場合は、当社のチームが支援します。豊富な経験と革新へのコミットメントを持つ当社に、ぜひご連絡ください。協力して、エンジニアリングの障害を成長と成功の機会に変えましょう。ぜひ今すぐお問い合わせください。