-
United States -
United Kingdom -
India -
France -
Deutschland -
Italia -
日本 -
대한민국 -
中国 -
台灣
-
Ansysは、シミュレーションエンジニアリングソフトウェアを学生に無償で提供することで、未来を拓く学生たちの助けとなることを目指しています。
-
Ansysは、シミュレーションエンジニアリングソフトウェアを学生に無償で提供することで、未来を拓く学生たちの助けとなることを目指しています。
-
Ansysは、シミュレーションエンジニアリングソフトウェアを学生に無償で提供することで、未来を拓く学生たちの助けとなることを目指しています。
Ansysブログ
November 1, 2022
2.5D/3D-ICチップ設計におけるシリコンインターポーザーの電磁界モデリングとシミュレーションの課題
2.5D/3D-ICパッケージング技術の採用により、マイクロチップ業界、特に中央処理装置(CPU)、グラフィックス処理装置(GPU)、システムオンチップ(SoC)などの高性能機器の分野が再び活発化し、ウルトラディープサブミクロンにおけるプロセスノードの進歩による収穫逓減が回避されました。ただし、パッケージング技術は複雑であるため、チップの設計からパッケージおよびプリント回路基板(PCB)の開発までのさまざまな開発チームが影響を受けました。
開発チームのニーズや要件は、それぞれ異なります。たとえば、チップを設計するチームは、電磁界、タイミング、電力、熱的影響、および機械的影響のモデリングとシミュレーションをサポートするツールが必要です。さらに、これらの現象の相互作用も捕捉しなければならず、マルチフィジックスシミュレーションをサポートするツール群が必要となり、要件は拡大します。このツール群は、マルチチップ2.5D/3D-IC設計の相互に影響するアーキテクチャ全体そして各チップレットに使用されます。
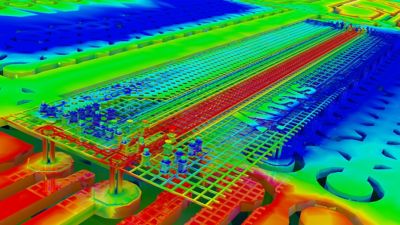
PCBおよびパッケージ開発者向けのツール要件も似ていますが、当然ながら広範になります。開発者が必要とするモデリングおよびシミュレーションツールは、パッケージおよび基板設計の電磁界、パワーインテグリティ、シグナルインテグリティ、熱特性、および機械特性を個別に捉えるだけでなく、マルチフィジックスの枠組みからも捉える必要があります。しかし、エンジニアは1つの完全なシステムとして基板、パッケージ、およびチップ間のマルチフィジックス相互作用を考慮しなければなりません。
こうした設計やシミュレーションに必要な技術の1つとしては、2.5D/3D-ICパッケージの基板からチップレット集積(フル3D-IC設計の場合はチップレット集積のスタック)を分離するインターポーザーがあります。インターポーザーは、水平面内ではダイを物理的に分離しながら、チップレットスタックの電力と信号の経路をパッケージのボールグリッドアレイ(BGA)にルーティングするための経路となります。
シリコンインターポーザーの利点
インターポーザーの材料として最近よく採用されているのはシリコンです。シリコンインターポーザーはIC製造プロセスを用いて製造され、一般的には高価となるものの、大きな利点があります。1つは材料の熱膨張係数であり、接触するダイの熱膨張係数と一致します。もう1つは、インターポーザーがサポートできるシリコン貫通ビア(TSV)の配置です。高密度で、BGAパッケージのボールピッチと適切に一致したアレイを実現できます。また、シリコンは、信号や電力の供給に用いられる配線を細かいピッチで配置することにも適しています。これらの優れた機能により、理論速度と帯域幅の性能面で大きなメリットとなります。
ただし、シリコンインターポーザーに高密度実装されるこれらすべての機能は、2.5D/3D-ICのチップ、パッケージ、および基板を設計するチームに新たな課題も生み出します。多数の機能が実装され密に連携しているシリコンインターポーザーのモデリングとシミュレーションのサポートは、複雑な課題です。また、マルチフィジックスの観点からも、あらゆる機能や機能システムが相互に関連しているシリコンインターポーザーは複雑なコンポーネントになります。
シリコンインターポーザーを使用する2.5D/3D-ICの設計者は、次のことを検討しなければなりません。
- 精度: 設計するシリコンインターポーザーのすべての詳細を電磁界シミュレータで正確に捉えることができるか。
- 実行時間: 設定したインターポーザー設計パラメータでシミュレーションを実行した場合、数分間ないし数時間で正確で最適な解に収束するか。
- マルチフィジックス: マルチフィジックスの完全解を得るために、インターポーザー電磁界シミュレーションに影響する可能性がある他の物理的要因(機械や熱の現象など)を含めることはできるか。
- システムシミュレーション: インターポーザーの電磁界シミュレーションをチップ、パッケージ、PCBレベルでの作業と組み合わせて、システムレベルでも正確なシミュレーションを短時間で実行できるか。
- 包括的な手法: 上記のすべてを達成できるツールセットのワークフローや手法があるか。
11月の第1週に開催された「3D-ICインターポーザー用の包括的なマルチフィジックス解析プラットフォーム」のウェビナーでは、こうした多くの質問にAnsysのエキスパートが回答しています。このウェビナーがきっかけとなり、チップレベルから完全なPCB実装までの3D-ICモデリングとシミュレーションに関するさまざまなディスカッションのためのウェビナーシリーズが開催されることになりました。11月3日のプレゼンテーションでは、3D-IC設計におけるパワーインテグリティ、熱的健全性、シグナルインテグリティの課題について説明し、インターポーザー設計の事例を用いて、その問題セットの包括的なマルチフィジックスシミュレーションソリューションとなるAnsys Redhawk-SC Electrothermalを紹介しました。
3D-IC設計の課題やソリューションについては、オンデマンドウェビナーを今すぐご覧ください。










