-
United States -
United Kingdom -
India -
France -
Deutschland -
Italia -
日本 -
대한민국 -
中国 -
台灣
-
Ansysは、シミュレーションエンジニアリングソフトウェアを学生に無償で提供することで、未来を拓く学生たちの助けとなることを目指しています。
-
Ansysは、シミュレーションエンジニアリングソフトウェアを学生に無償で提供することで、未来を拓く学生たちの助けとなることを目指しています。
-
Ansysは、シミュレーションエンジニアリングソフトウェアを学生に無償で提供することで、未来を拓く学生たちの助けとなることを目指しています。
Ansysブログ
May 3, 2023
3D-IC設計:チップ集積の革新的なアプローチ
テクノロジーの進歩により、ますます複雑で高密度な集積回路(IC)が開発されています。高性能で電力効率の高いデバイスに対する需要の高まりに対応するため、業界は3D-IC設計に移行しています。3D-ICは、消費者向けエレクトロニクス製品、通信、コンピューティング、自動車など、さまざまな業界における多様な用途で採用されています。
3D-IC技術とは
3D-IC技術とは、「チップレット集積」と呼ばれる複数の半導体チップを互いの近くに配置する2.5D-IC、または重ねて配置する3D-ICなどのマルチダイ集積回路のさまざまなパッケージング技術を指します。チップレット集積は、シリコンインターポーザーとシリコン貫通ビア(TSV)を使用して相互接続され、シリコンインターポーザーを貫通してすべての層が接続されます。TSVはインターコネクトの長さが短く、寄生容量が小さく、帯域幅が広いため、システム性能が向上します。この技術により、ロジック、メモリ、センサー、微小電気機械システム(MEMS)などの分野で、異なる種類のチップをコンパクトなフォームファクターで集積できるようになり、性能の向上、消費電力の削減、フォームファクターの削減を達成できます。

3D-ICが優れた代替技術である理由
システムオンチップ(SoC)は、より高い性能と拡張された機能を提供するため、あらゆるIC設計者の第一選択肢となります。しかし、SoCは一体化された形態であり、混在する素子を1つのダイに集積するために製造に時間を要し、結果として全体的なコストが増加します。
SoCの設計手法にはいくつかの制限事項があります。主な制限事項の1つはチップ自体のサイズです。電子システムの全コンポーネントが単一のチップに配置されるため、サイズが制限されます。つまり、SoCに集積できるコンポーネントの数とタイプは、チップ上で利用できるスペースによって制限されます。
SoC設計のもう1つの制限事項は、製造プロセスのコストと複雑さです。多数のコンポーネントが1つのチップに集積されるため、高度な半導体製造プロセスが必要になり、プロセスは複雑に、コストは高くになります。こうした理由から、SoCの大量生産は困難で、商用化の実現可能性にも影響します。
また、すべてのコンポーネントがSoCパッケージに密に実装されているため、消費電力が増加し、性能が低下します。高度な集積によって、システムの柔軟性とアップグレード性も制限されます。つまり、SoC設計には小型化や複雑さの軽減など多くの利点はあるものの、このアプローチの採用を決定する前に、潜在的な制限事項を慎重に検討することが重要です。
上記の制限事項により、設計者はより革新的なアプローチである3D-IC設計に着目するようになりました。このアプローチには、性能の向上、消費電力の削減、フォームファクターの削減など、従来の2D-IC設計に比べていくつかの利点があります。また、従来の2D-ICと比較して、異種チップの集積、スペースの有効利用、電気性能の向上が可能になります。
3D-ICは、シリコンインターポーザーとTSVを使用することで、異なるIP間の接続性を向上させます。シリコンインターポーザーは、2.5D-ICおよび3D-IC設計で使用されるシリコンの薄いウェハで、単一のパッケージ上で複数のダイまたはチップを接続します。微細ピッチで配置された垂直TSVとマイクロバンプを使用してダイが配置され、接続される基板となります。これにより、従来の2D-ICと比較して、熱放散の向上、消費電力の削減、高密度化、電気性能の向上が可能になります。
3D-ICの設計上の課題
3D-IC設計には、伝熱、エレクトロマイグレーション、応力とひずみ、熱膨張など、マルチフィジックスに関するいくつかの課題があります。これらの課題は、複数のダイが重なり合って配置され、TSVやマイクロバンプを用いて接続される、3D-ICの複雑で相互に接続された特質によって生じます。
3D-IC設計における課題の1つには熱膨張もあります。ICの温度が変化すると、ICに使用される各種の材料が異なる速度で膨張し、応力や反りが発生して、性能と信頼性が低下します。また、伝熱が原因で3D-IC設計における温度分布がさらに複雑になることもあります。3D-ICでは、トランジスタやその他のコンポーネントが高密度で集積されるため、伝熱が複雑になり、熱の大部分がシステム内に閉じ込められるため、温度の上昇に寄与します。これが「自己発熱」と呼ばれる現象です。3D-ICは、長いインターコネクト線を介して接続される数十億個のコンポーネントで構成されます。こうした長い接続によるジュール発熱も、全体的な温度上昇に寄与する大きな問題点です。3D-ICを設計する際、信頼性の高い性能を確保するためには、これらの熱源を監視して解析する必要があります。
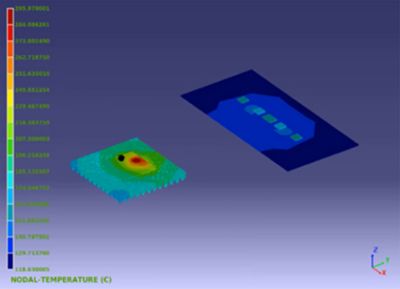
マルチダイ3D-ICシステムにおける熱分布
Ansys RedHawk-SC Electrothermalは、シリコンインターポーザーを使用した3D-IC設計の熱挙動を調査してシミュレーションするための業界標準のテクノロジーを提供します。シリコンインターポーザーを含め、3D-IC設計のジオメトリおよび材料特性を簡単にモデル化し、設計段階での伝熱をシミュレーションできます。また、温度分布と熱放散を簡単に解析して、要求された熱性能仕様を設計が満たしているかどうかを確認することもできます。
3D-IC設計におけるもう1つの大きな課題は、エレクトロマイグレーションです。これは導体内の電子の動きを指しますが、時間経過とともにICに損傷を与える可能性があります。この問題は3D-ICにおいては特に深刻です。コンポーネントの高い電流と密度が原因で、エレクトロマイグレーションのリスクが高まります。Ansys Redhawk-SCを使用することで、エレクトロマイグレーションの信頼性のサインオフを確実に行えるようになります。
IC設計者にとって、パワーインテグリティとシグナルインテグリティは常に最大の懸念事項です。パワーインテグリティのサインオフは、複雑なジオメトリを持つ3D-ICでは一層複雑になります。出力と温度の関係は、それをさらに複雑にします。システム内の各ブロックの消費電力が異なるため、各ブロックの周囲の温度分布も異なります。システムのパワーインテグリティを最適化するには、3D-ICで生じる、こうしたマルチフィジックスの問題を解決する必要があります。Ansysのツールを使用することで、ブロックの電力モデルを作成し、システムの挙動をシミュレーションすることが容易になります。
3D-ICの設計は、小さなフォームファクターを達成するチップ集積の革新的なアプローチですが、マルチフィジックスに関する多くの課題があります。これらのマルチフィジックス課題に対処することは、設計と実装を成功させる上で不可欠です。Ansysのツールは、クラス最高のシミュレーションテクノロジーを提供し、課題に簡単に対処できる機能を備えています。3D-ICのシグナルインテグリティ、パワーインテグリティ、熱的健全性を簡単に解析して、必要な性能仕様を満たしていることを確認できます。
RedHawk-SCの詳細はこちらをご覧ください。また、関連するウェビナー「シリコンインターポーザー設計における熱的健全性に関する問題と解決方法」もあわせてご覧ください。










