-
United States -
United Kingdom -
India -
France -
Deutschland -
Italia -
日本 -
대한민국 -
中国 -
台灣
-
-
產品系列
查看所有產品Ansys致力於為當今的學生打下成功的基礎,通過向學生提供免費的模擬工程軟體。
-
什麼是微晶片?
微晶片是一種電子裝置,由一小片平坦的半導體材料製成,透過添加其他摻雜物、氧化物和金屬來加以修改以製造出電子元件,其中包括在電路中連接的電晶體、二極體、電阻器和電容器。
微晶片也稱為:
- 積體電路 (IC)
- 電腦晶片
- 半導體
- 晶片
積體電路已取代由電線或印刷電路板 (PCB) 連接之獨立元件的組件,因為它們是一種小很多的單一單晶裝置,耗電量少很多,且能夠在成本大幅降低的情況下進行大量生產。
半導體材料是在 1821 年由 Thomas Johann Seebeck 所發現,而第一個使用的半導體電晶體則是在 1947 年由 Willam Shockley 所打造。元件及其所有互連是在 1959 年由 Robert Noyce 結合為單一裝置。這項發明及後續所有項目的關鍵在於平面製造程序,其使用微影製程,以精確的方式一次一層地沉積並移除材料。
積體電路是現代生活中不可或缺的一部分,為範圍從玩具到深空探測器的裝置提供電子。2023 年,微晶片銷售的全球營收為 5269 億美元。當年的銷售也表明,晶片的使用範圍進一步擴展到電腦以外的領域:32% 用於通訊,17% 用於汽車應用,14% 用於工業裝置,11% 用於消費性電子,僅 25% 用於運算。
在摩爾定律的驅動下,IC 中的電晶體數量每兩年就會翻倍,電路越來越複雜且元件不斷縮小,使得每一代晶片在設計和製造微晶片方面面臨的挑戰性越來越高。
晶片上個別元件的一般尺寸稱為特徵尺寸,會使用奈米 (nm) 或十億分之一公尺進行測量。目前的半導體製造商採用 14-nm、10-nm、7-nm、5-nm 和 3-nm 製程,而 2-nm 技術即將投入使用。就比例而言,一粒米的長度為 500 萬奈米。
2023 年,研究人員打造了一款破紀錄的微處理器,內含 1.2 兆個電晶體。在 Intel 2024 年的 CPU 系列中,單一晶片上包含超過 1 億個電晶體。
典型微晶片的元素
積體電路由半導體材料 (通常為矽) 製成,這些材料會堆疊在重疊層中。以下是微晶片中最常見的元素:
- 矽基板:基礎的純矽晶體層,會從此層透過移除或沉積其他材料或摻雜晶體材料來建構其他層。
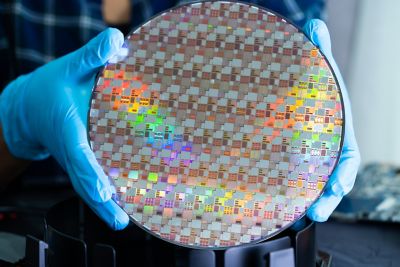
- 層:電子電路會在個別層上建立。層會以微影製程、蝕刻和沉積來修改,以產生所需元件和互連。有些層也可作為電子絕緣體使用。
- 通孔:導電區域,通常為圓柱形,用來在層之間傳輸電子訊號。

- 元件:構成所需電路的電子裝置。在大多數 IC 中,這些裝置包含電晶體、電容器、二極體、電阻器,有時也包含電感器。
- 互連:所指定層上的金屬化路徑,會在元件之間或向通孔導電。

- 封裝:完成後,IC 會放在稱為半導體封裝的組件中以對精密矽晶片進行保護及絕緣,且其可連接多個晶片,並提供將一或多個晶片連接到大型電子電路的方式。
微晶片的 製造方式
微晶片製造有三個步驟。每個步驟都經過高度最佳化和自動化,以將成本降至最低、確保品質並將效率最大化。設計 IC 的工程師需要充分瞭解製造程序,因為每個步驟都會決定元件的尺寸、形狀和間距。
步驟 1:晶圓生產
製造空白矽晶圓是半導體製造的第一步。此程序從半導體材料 (通常為純矽) 的單晶圓柱形錠 (稱為晶錠) 生長開始。然後,將晶錠切成薄型晶圓,加工以產生平坦表面,化學蝕刻以去除加工造成的任何損壞,並進行拋光。電子晶圓的直徑通常為 100 到 450 mm。最常見的尺寸為 300 mm,厚度為 755 µm。
步驟 2:製造
電路及其所有元件和互連,都會在半導體製造廠 (通常稱為晶圓廠) 中建立。每層和電路拓撲都會以一系列高度控制的步驟建立。機器人會在叢集中將晶圓從一個機器移至另一個機器。大多數晶片製造程序都會針對每層按照以下步驟操作:
- 增加一個二氧化矽層,以完全覆蓋該層 (也稱為鈍化)。
- 添加光阻劑塗層。
- 依照您想建立的幾何圖案,將光阻劑層暴露於紫外光下。然後對光阻劑層進行顯影,並移除暴露於光下的材料。這稱為微影製程。
- 使用化學物質 (通常為強酸) 移除已去除光阻劑的氧化層。這稱為蝕刻。
- 移除未顯影的光阻劑材料。
- 如果層需要摻雜,離子植入污染物到晶體結構中,會針對電晶體和其他元件產生所需半導體行為。
- 針對其他材料,會使用各種形式的化學或氣相沉積來建立互連、通孔及其他元件。
步驟 3:封裝
在每一層都建構完成且晶圓經過清潔及測試之後,會將其切割成稱為晶粒的個別晶片。然後,會透過黏合將一或多個晶粒連接至結構,並根據應用將 IC 封裝在不同材料中。有些封裝包含單一晶片,但目前的趨勢是將多個晶粒結合為單一封裝。
微晶片類型和用途
積體電路的類型和用途每年都在增長。早期的 IC 通常僅執行單一功能。但是,隨著製造技術和設計工具的改善,晶片已經轉變為多功能。
智慧型手機是可以將多種類型的晶片結合在單一裝置中以因應不同用途的絕佳範例。它們包含用於 5G 無線電和 GPS 的射頻 (RF) 晶片、用於相機的光電晶片、用於顯示器的 LED 晶片、用於處理器的數位 IC、用於加速度計的微機電系統 (MEMS) 晶片,以及十多種其他積體電路來感應、控制及修改大量用途。
不同類型的晶片可以根據其執行的傳訊來進行分類。
類比積體電路
類比訊號會在連續電壓範圍內傳輸電壓,而不僅是高或低電壓訊號。它們會用來放大、依頻率濾波及混合訊號。類比 IC 的頻率和功率可以差異很大,而更高的頻率和更高的功率則代表著重大的設計挑戰。
類比 IC 的常見用途包括:
- 光學、熱和音訊感應器
- 電源管理電路
- 運算放大器 (op-amp)
- 音訊和視訊訊號處理
- 電信,包括無線電通訊和光學訊號處理
- RF 電路
- 訊號調節
- 機器控制器
數位積體電路
數位 IC 是邏輯裝置,包含由電晶體製成的數百萬個或數十億個邏輯閘。以固定時脈頻率運行的訊號會修改或測量為高或低,零或一。藉由結合不同的邏輯裝置,能夠以極少的功耗完成非常複雜的計算。
數位 IC 的一些最常見用途包括:
- 邏輯 IC 或處理器
- 微處理器
- 微控制器
- 特定應用積體電路 (ASIC)
- 記憶體晶片
- 現場可程式化閘道陣列 (FPGA)
- 數位電源管理裝置
- 系統單晶片 (SoC) 裝置
- 多晶粒晶片
混合訊號積體電路
一些積體電路會結合電路以處理類比和數位訊號,並在兩者之間轉換以建立混合訊號積體電路。當感應或建立類比訊號,且需要邏輯運算才能讀取、建立或修改該訊號時,會使用這些電路。
混合訊號 IC 的一些最常見用途包括:
微晶片技術的未來趨勢
微晶片的未來就像過去一樣,能以更小的尺寸提供更多的功能,同時不斷降低成本。製造的進步也將為更好的效能和新的應用創造新的機會。
在不遠的將來推動電子工程設計和模擬的趨勢包括:
轉變為無晶圓廠設計和晶圓代工廠
業界多年來已轉變為一個模型,即公司可以設計自己的 IC,然後將製造外包給專門製造晶片的公司。這稱為無晶圓廠設計,而合約製造商稱為晶圓代工廠。如此一來,Apple 和 Qualcomm 等公司便可設計創新的新產品,而不需要投入資本來建造自己的製造廠。工程師必須根據他們將使用的晶圓代工廠的製造程序和標準進行設計。
更小的特徵尺寸
特徵尺寸持續縮小,進而產生電源和訊號完整性問題。為了保持競爭力,電子工程師需要使用這些新功能進行設計,並利用模擬和設計最佳實作範例來避免產生問題。
電子裝置複雜度和結合的功能
隨著時間的推移,越來越多的電子裝置設計師希望在單一晶片中實現更強大的功能。物聯網 (IoT) 裝置、新固態長期儲存裝置和 GPU 晶片是積體電路的範例,其不僅會在相同晶片中增加新特色和功能,而且這些功能之間的交互作用也會變得更複雜。工程師需要設計和模擬工具來推動設計以便產業推動技術發展。生物醫學電子 (例如植入的微晶片) 將成為另一個需要在單一晶片上整合多種功能的領域。
更高的時脈速度和頻率
增加的 RF 技術效能需求與進步,會提高數位 IC 的時脈速度以及類比和混合訊號晶片的頻率。這兩者都會產生訊號完整性和電源管理問題。
更優異的電腦功能和提高的能源效率
高效能運算資料中心增長以支援人工智慧、加密貨幣挖掘和 IoT 應用等趨勢,正在推動對微處理器效能提升的需求。這些應用正在推動產業改進 FPGA、固態硬碟、記憶體和 GPU,以及以不斷提高的資料傳輸速度連接所有項目需要的所有晶片。
超越運算範圍的更多用途
微晶片在汽車、消費性電子和工業應用中的使用增加趨勢將會持續。幾乎所有產品都將設計為智慧型裝置,具備寬頻、感應器和運算能力的連線能力,而所有這些都需要微晶片。
微晶片設計中的模擬
微晶片製造的複雜度和費用,使得實體原型設計不切實際。工程師會改用透過模擬的虛擬原型設計來推動他們的設計、驗證效能,並在生產開始之前找出並解決問題。模擬也會用來設計封裝並最佳化製造晶片的半導體製造機器。
針對數位微晶片使用模擬,會從使用 RTL 設計驗證抽象層級數位設計的邏輯功能開始。這包括使用 Ansys PowerArtist™ 軟體初步瞭解電源管理。此工具可以在程序早期評估設計的電力需求,且有助於推動更省電的設計。
配置實體設計後,工程師可以使用 Ansys RedHawk-SC™ 軟體 (數位 IC 電源雜訊和可靠性之值得信賴的業界領導者) 來評估其設計中的電壓降和電遷移。
在項目的類比和混合訊號方面,可以將 Ansys Totem™ 軟體導入程序,以進行電源完整性和可靠性簽核。這是業界值得信賴的電遷移多重物理量黃金標準,已通過所有主要的晶圓代工廠認證,適用於連 3 nm 都包括在內的製程。它也會與 Ansys PathFinder-SC™ 軟體搭配使用,來計算靜電放電。
在最佳化及驗證設計之後,封裝工程師可以使用模擬來最佳化整個微晶片封裝的電源、訊號完整性和穩健性。RedHawk-SC 軟體的設計旨在處理大型多晶片配置,包括系統級封裝設計。先進半導體封裝會使用 2.5D- 和 3D-IC 方法來在相同封裝中結合及連接多個晶粒,而使用 RedHawk-SC 軟體模擬是驗證及最佳化設計的主要方式。
解決設計的電子問題之後,封裝工程師可以使用 Ansys Mechanical™ 軟體和 Ansys Icepak® 工具來進行結構可靠性和熱管理。
相關資源
讓我們開始吧
如果您面臨工程挑戰,我們的團隊將隨時為您提供協助。憑藉豐富的經驗和對創新的承諾,我們邀請您與我們聯絡。讓我們共同合作,將您的工程障礙轉化為成長和成功的機會。立即與我們聯絡,開始對話。










