-
United States -
United Kingdom -
India -
France -
Deutschland -
Italia -
日本 -
대한민국 -
中国 -
台灣
-
-
產品系列
查看所有產品Ansys致力於為當今的學生打下成功的基礎,通過向學生提供免費的模擬工程軟體。
-
ANSYS 部落格
November 1, 2022
在 2.5D/3D-IC 晶片設計進行矽中介層電磁建模和模擬所面臨的挑戰
2.5D/3D-IC 封裝技術的運用,不僅為微晶片產業重新注入了活力,尤其是中央處理器 (CPU)、圖形處理器 (GPU) 和系統單晶片 (SoC) 等高階產品,同時規避了超深次微米製程節點進展所導致的報酬率遞減問題。不過,封裝技術相當複雜,其影響更是擴及晶片設計到封裝及印刷電路板 (PCB) 開發等不同設計團隊。
這些開發團隊各有各的要求與需求。晶片團隊所需的工具,必須能支援電磁學、定時、電源、熱效應與機械效應的建模與模擬作業。不僅如此,還要能擷取這些現象的交互作用,並能有效地擴展至支援多物理模擬工具組的需求。此套工具組將應用至每個小晶片及多晶片 2.5D/3D-IC 設計的整體動態互動架構。
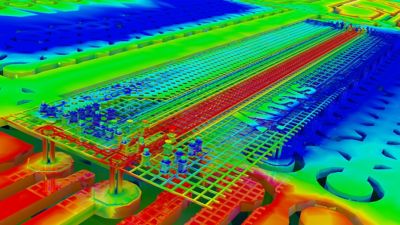
至於 PCB 和封裝開發者工具的需求相當類似,但顯然更為廣泛。其建模與模擬工具,不論是單獨使用還是從多物理的參考架構來看,都需要能保護封裝與電路板設計的電磁學、電源與訊號完整性、熱與機械層面等特性。然而,工程師還必須從完整系統的角度,考量電路板、封裝和晶片之間的多物理交互作用。
在所有設計與模擬中,最為重要的是將小晶片 (或完整 3D-IC 設計中的小晶片堆疊) 與 2.5D/3D-IC 封裝基板相隔離的中介層。中介層在水平面上實質分離晶粒,同時提供路徑以利小晶片堆疊電源和訊號前往封裝上的球柵陣列 (BGA)。
矽中介層的優勢
用於製造這種元件的材料中,矽正是逐漸廣獲採用的選項。矽中介層是使用 IC 製程製造而來,雖然造價一般較為昂貴,卻能提供顯而易見的優勢。一是材料的熱膨脹係數與其接觸晶粒的熱膨脹係數相符。一是中介層可支援矽通孔 (TSV) 配置。該陣列不僅密集,又能妥善對齊 BGA 封裝的焊球間距。此外,矽支援用於訊號和配電的細間距軌跡線。矽中介層結合了這些功能,在原始速度和頻寬方面便展現出有目共睹的效能優勢。
不過,矽中介層的這些密集封裝特色,卻為 2.5D/3D-IC 晶片、封裝和電路板設計團隊帶來了更多的問題。矽中介層在支援建模與模擬方面無疑是一大挑戰,從中可見還有很大的進步空間。另外,從多物理的角度而言,矽中介層在彼此緊密相連的功能及性能系統中,同樣屬於複雜精密的一款元件。
2.5D/3D-IC 設計師在使用矽中介層時,會擔心下面的問題:
- 準確度:電磁模擬器是否能準確擷取到矽中介層的所有細節?
- 執行時間:模擬是否能在相關時間內 (例如幾分鐘或幾小時),將具準確度的最佳解決方案,收斂至我的中介層設計參數上?
- 多物理:是否能納入其他物理要素 (例如會影響到中介層電磁 (EM) 模擬的機械與熱現象),以提出完整的多重物理量解決方案?
- 系統模擬:我的中介層電磁模擬是否能結合晶片、封裝和 PCB 層級上的作業,並仍能在系統層級及時產生準確的模擬結果?
- 全方位方法:工具組是否具備可執行上述所有項目的工作流程或方法?
Ansys 在十一月首週舉行的線上研討會「適用於 3D-IC 中介層的全方位多重物理量分析平台」,詳盡答覆了這些問題及其他提問。這場線上研討會針對 3D-IC 建模和模擬展開一連串的會中討論,內容從晶片層級延伸至完整 PCB 實作。11 月 3 日發表的簡報闡述了設計 3D-IC 時面臨的電源完整性、熱完整性和訊號完整性等挑戰,並以採用中介層設計的 Ansys Redhawk-SC Electrothermal (針對種種問題而提出的全方位多物理模擬解決方案) 作為說明應用範例。
立即觀看隨選線上研討會,瞭解 3D-IC 設計面臨的所有挑戰和解決方案。










