-
United States -
United Kingdom -
India -
France -
Deutschland -
Italia -
日本 -
대한민국 -
中国 -
台灣
-
-
产品组合
查看所有产品Ansys致力于通过向学生提供免费的仿真工程软件来助力他们获得成功。
-
Ansys博客
May 3, 2023
3D-IC设计:芯片集成的创新方法
技术的进步推动了日益复杂和密集的集成电路(IC)不断发展。为了满足对高性能和节能设备不断增长的需求,行业已转向3D-IC设计。3D-IC在消费类电子产品、电信、计算和汽车等众多行业都有广泛的应用。
什么是3D-IC技术?
3D-IC技术是指用于多芯片集成电路的一系列封装技术,其中多个半导体芯片(称为“芯粒”)彼此靠近(2.5D-IC)或相互叠放(3D-IC)。这些芯粒(Chiplet)使用带硅通孔(TSV)的硅中介进行互连,这些通孔穿过硅中介并实现所有层之间的连接。TSV可提供更短的互连长度、更低的寄生电容和更高的带宽,从而提高系统性能。该技术,可以在紧凑的外形尺寸中实现逻辑、存储器、传感器、微机电系统(MEMS)等领域芯片的异构集成,从而实现更高的性能、更低的功耗和更小的外形尺寸。

为什么3D-IC技术是更好的替代方案?
片上系统(SoC)是每个IC设计人员的首选,因为它可提供更高的性能和扩展的功能。但SoC是单片的,而将混合元件集成到单个芯片会延迟产品交付,并增加IC的整体成本。
SoC设计方法有几个局限性。主要限制之一是芯片本身的尺寸。因为电子系统的所有组件都放在单个芯片上,这意味着可以集成到SoC上的组件数量和类型受到芯片上可用空间的限制。
SoC设计的另一个局限性是制造工艺的成本和复杂性。由于许多组件集成在单个芯片上,因此需要先进的半导体制造工艺。这不仅成本高昂而且相当复杂,会给大批量生产SoC带来挑战,并可能限制其商业可行性。
由于所有组件都紧密封装在SoC封装中,因此会导致功耗增加、性能下降。此外,高度集成还会限制系统的灵活性和可升级性。总的来说,虽然SoC设计具有许多优势,例如尺寸更小、复杂性相对更低,但在决定使用此方法之前,必须仔细考虑其潜在的局限性。
上述局限性,促使设计人员采用更具革命性的方法:3D-IC设计。与传统的2D-IC设计相比,这种方法具有多种优势,包括提高性能、降低功耗和缩小外形尺寸。此外,相较于2D-IC,3D-IC设计技术还可实现异构集成,更高效地利用空间并提高电气性能。
3D-IC使用硅中介(silicon interposer)和TSV,以便在不同IP之间实现更好的连接。硅中介是一种用于2.5D和3D-IC设计的薄硅晶片,可以在单个封装中连接多个裸片或芯片。它可作为放置芯片的基板,并使用较小间距垂直TSV和微突进行连接。与传统的2D-IC相比,这可以实现更好的散热、更低的功耗、更高的密度和更出色的电气性能。
3D-IC的设计挑战
3D-IC设计面临一些多物理场挑战,包括传热、电迁移、应力和应变以及热膨胀。这些挑战是由于3D-IC的复杂性和互联性而产生的,其中多个芯片相互堆叠,并使用TSV和微突进行连接。
热膨胀也是3D-IC设计中的一项挑战。随着IC温度的变化,IC中使用的不同材料将以不同的速率膨胀,从而导致应力和翘曲,影响其性能和可靠性。传热会使3D-IC设计中的温度分布进一步复杂化。由于晶体管和其他组件的高密度,3D-IC中的传热变得非常困难。大多数热量都滞留在系统中,导致温度升高。这种现象被称为自热。3D-IC由数十亿个组件组成,这些组件通过较长的互连线连接。这些长连接产生的焦耳热,是导致整体温度升高的另一个主要因素。在设计3D-IC时,必须对这些热源进行监控和分析,以确保可靠的性能。
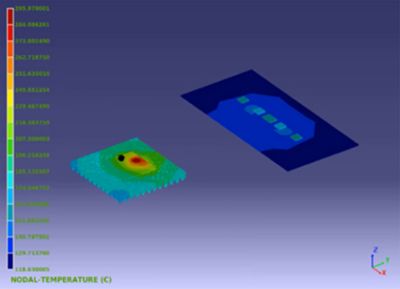
多芯片3D-IC系统中的热分布
Ansys Redhawk-SC Electrothermal提供了一种黄金标准技术,用于进行使用硅中介的3D-IC设计的热行为仿真和检查。您可以轻松地对3D-IC设计(包括硅中介)的几何结构和材料属性进行建模,并对设计中的传热进行仿真。此外,您还可以轻松分析温度分布和散热,以查看设计是否符合所需的热性能规范。
电迁移是3D-IC设计中的另一个主要挑战。这是指电子在导体内的运动,随着时间的推移会对IC造成损坏;而由于组件的高电流和密度会增加电迁移的风险,其在3D-IC中尤其成问题。不过,利用Ansys RedHawk-SC,工程师无需反复思考就可以进行电迁移可靠性签核。
电源完整性和信号完整性始终是IC设计人员最关心的问题。由于3D-IC复杂的几何结构,其电源完整性签核更为复杂。功率和温度之间的关系使这一问题更加复杂。系统中每个模块的功耗不同,这就会在每个模块周围产生不同的温度分布。为了优化系统的电源完整性,设计人员必须克服3D-IC中存在的这些多物理场问题,而利用Ansys软件,设计人员可以轻松生成模块的电源模型,并对系统的行为进行仿真。
3D-IC设计是一种变革性的芯片集成方法,它可提供小巧的外形尺寸,但也面临许多多物理场挑战。因此,解决这些多物理场挑战对于成功设计和实施至关重要。通过提供业界领先的仿真技术,Ansys工具能够助您轻松应对上述挑战——您可以轻松分析3D-IC的信号完整性、电源完整性和热完整性,以确保您的设计符合所有要求的性能规范。
了解RedHawk-SC,并查看我们的相关网络研讨会“硅中介设计的热完整性挑战和解决方案”。










