-
United States -
United Kingdom -
India -
France -
Deutschland -
Italia -
日本 -
대한민국 -
中国 -
台灣
-
Ansys는 학생들에게 시뮬레이션 엔지니어링 소프트웨어를 무료로 제공함으로써 오늘날의 학생들의 성장을 지속적으로 지원하고 있습니다.
-
Ansys는 학생들에게 시뮬레이션 엔지니어링 소프트웨어를 무료로 제공함으로써 오늘날의 학생들의 성장을 지속적으로 지원하고 있습니다.
-
Ansys는 학생들에게 시뮬레이션 엔지니어링 소프트웨어를 무료로 제공함으로써 오늘날의 학생들의 성장을 지속적으로 지원하고 있습니다.
ANSYS 블로그
November 1, 2022
2.5D/3D-IC 칩 설계의 실리콘 인터포저에 대한 전자기 모델링 및 시뮬레이션의 과제
2.5D/3D-IC 패키징 기술의 사용은 마이크로칩 산업, 특히 중앙 처리 장치(CPU), 그래픽 처리 장치(GPU), 시스템 온 칩(SoC)과 같은 하이엔드 분야에서 초미세 서브미크론의 공정 노드 발전으로 인한 수익 감소를 극복하고 새로운 활력을 불어넣어 주었습니다. 그러나 패키징 기술은 복잡하며 칩 설계부터 패키지 및 인쇄 회로 기판(PCB) 개발에 이르기까지 설계 팀 전반에 걸쳐 영향을 미칩니다.
이러한 개발 팀은 서로 다른 요구 사항과 니즈가 있습니다. 칩 팀은 전자기, 타이밍, 전력, 열 영향 및 기계적 영향에 대한 모델링과 시뮬레이션을 지원하는 툴이 필요합니다. 또한 이러한 현상의 상호 작용을 포착하여 다중물리 시뮬레이션을 지원하는 툴 세트로 요구 사항을 효과적으로 확장해야 합니다. 이 툴 세트는 각 칩렛과 멀티칩 2.5D/3D-IC 설계의 전체 동적 상호연관된 아키텍처에 적용됩니다.
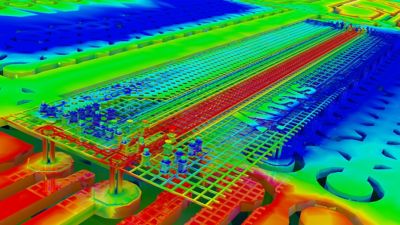
PCB 및 패키지 개발자 툴 요구 사항은 매우 유사하지만 확실히 더 광범위합니다. 모델링 및 시뮬레이션 툴는 패키지 및 보드 설계의 전자기학, 전력 및 신호 무결성, 열 및 기계적 측면을 개별적으로 그리고 다중물리 기준 프레임으로부터 보호해야 합니다. 그러나 엔지니어는 보드, 패키지, 칩 간의 다중물리 상호 작용도 완전한 시스템으로 고려해야 합니다.
2.5D/3D-IC 패키지의 기판에서 전체 3D-IC 설계의 기판 또는 기판 스택을 분리하는 인터포저는 모든 설계 및 시뮬레이션 필수품 내에 중첩되어 있습니다. 인터포저는 수평면에서 다이를 물리적으로 분리하는 동시에 칩렛 스택 전원을 연결하기 위한 경로와 패키지의 BGA(볼 그리드 어레이)에 대한 신호 경로를 제공합니다.
실리콘 인터포저의 장점
이 요소를 구성하는 재료로 점점 인기가 높아지고 있는 것은 실리콘입니다. 실리콘 인터포저는 IC 제조 공정을 사용하여 제작되며 일반적으로 더 비싸지만 뚜렷한 장점을 제공할 수 있습니다. 그중 하나는 접촉하는 다이의 열팽창 계수와 일치하는 재료의 열팽창 계수입니다. 또 다른 하나는 인터포저가 지원할 수 있는 TSV(Through Silicon Via) 배열입니다. 어레이는 밀도가 높을 뿐만 아니라 BGA 패키징의 볼 간격과 잘 정렬될 수 있습니다. 또한 실리콘은 신호 및 전력 분배에 사용되는 트레이스에 대해 미세한 간격을 지원합니다. 이러한 기능은 함께 실제 속도 및 대역폭 측면에서 상당한 성능 이점을 제공합니다.
그러나 실리콘 인터포저에 밀집되어 있는 이러한 모든 기능은 2.5D/3D-IC 칩, 패키지 및 보드를 설계하는 팀 구성원에게 추가적인 문제를 안겨줍니다. 실리콘 인터포저에 대한 모델링 및 시뮬레이션 지원은 많은 일이 진행되고 있음을 알 수 있는 중요한 과제입니다. 더욱이, 실리콘 인터포저는 다중물리 관점에서 모두 상호 연관된 기능 및 성능 시스템의 또 다른 복잡한 구성 요소입니다.
실리콘 인터포저를 사용하는 2.5D3/D-IC 설계자의 우려 사항은 다음과 같습니다.
- 정확도: 전자기 시뮬레이터가 실리콘 인터포저의 모든 세부 사항을 정확하게 캡처할 수 있는가?
- 실행 시간: 시뮬레이션이 몇 분 또는 몇 시간과 같은 관련 시간에 인터포저 설계 매개변수에 대한 정확하고 최적의 솔루션으로 수렴되는가?
- 다중물리: 인터포저 전자기(EM) 시뮬레이션에 영향을 미칠 수 있는 기계적 및 열적 현상과 같은 다른 물리적 요인을 포함하여 완전한 다중물리 솔루션을 제공할 수 있는가?
- 시스템 시뮬레이션: 인터포저 EM 시뮬레이션을 칩, 패키지 및 PCB 수준의 작업과 결합하면서도 시스템 수준에서 정확하고 시기적절한 시뮬레이션을 생성할 수 있는가?
- 포괄적인 방법론: 위의 모든 항목을 실행할 수 있는 도구 세트에 대한 워크플로나 방법론이 있는가?
Ansys는 11월 첫째 주에 열린 "3D-IC 인터포저를 위한 종합 다중물리 분석 플랫폼" 웨비나에서 이러한 질문과 더 많은 질문에 대한 답변을 얻었습니다. 이 웨비나는 칩 수준에서 전체 PCB 구현까지 확장되는 3D-IC 모델링 및 시뮬레이션에 대한 확장된 웨비나 토론 시리즈를 시작했습니다. 11월 3일 프레젠테이션에서는 3D-IC 설계의 전력 무결성, 열적 무결성 및 신호 무결성 문제를 간략하게 설명하고 인터포저 설계를 예시로 사용하여 문제 세트에 대한 포괄적인 다중물리 시뮬레이션 솔루션인 Ansys Redhawk-SC Electrothermal을 제시했습니다.
지금 온디맨드 웨비나를 보고 3D-IC 설계의 과제와 솔루션에 대해 모두 알아보십시오.










